Solderon™BP IN 1000铟电镀化学设计用于先进的晶圆级封装的焊接电镀工艺,对温度敏感的新兴应用。它的使用最大限度地减少了衬底的翘曲和应力,并降低了在精密器件中由于显著降低回流温度而损坏材料的可能性。Solderon™BP IN 1000铟达到了优化性能、多功能性和拥有成本要求的平衡。它将Solderon™系列扩展到不能使用SnAg的应用程序。
|
光电子键合/组装(多传感CMOS图像传感器、显示器) |
|---|
|
3D硅晶片堆垛 |
|
柔性和/或无芯衬底组装 |
|
热敏传感器 |
|
化合物半导体(III-V材料) |
多功能性
Solderon™1000年BP铟是一组广泛的应用程序,从C4疙瘩传统倒装芯片的过程,为铜柱、限制和3 dµ疙瘩叠加使用TSV流程(图1和图2),也兼容主流撞光刻胶材料,并且可以直接集成到现有的流程。在试验车辆碰撞和封盖过程中,证明了良好的模具内共平面性。此外,它的低熔化温度也使它成为一个良好的选择,以粘结多层薄层。
性能
Solderon™BP IN 1000铟达到低温回流(图3),峰值温度约180°C(取决于剖面优化)。这比典型的SnAg回流温度低80°C。该材料显示宏观和微观无空隙性能,甚至在多次流后形成各种下凸点金属化材料的可靠互连(图4)。最后,Solderon™BP IN 1000铟提供稳定和一致的性能,在热和电解时效(图5)。
C4撞应用程序
铜柱封顶应用

图1:Solderon™BP IN 1000铟具有广泛的应用,包括多(薄)层粘接,C4撞击应用和铜柱盖。电镀条件:2 ASD, 25°C。
C4撞应用程序
铜柱封顶应用
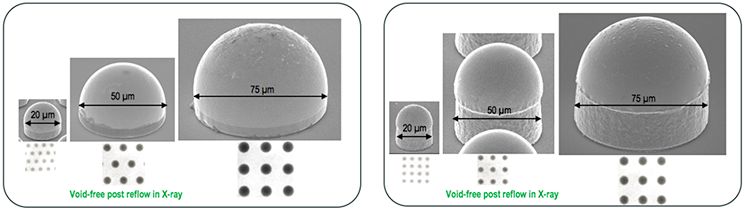
图2:Solderon™BP IN 1000铟可用于大范围的碰撞和矿柱尺寸。电镀条件:2 ASD, 25°C。
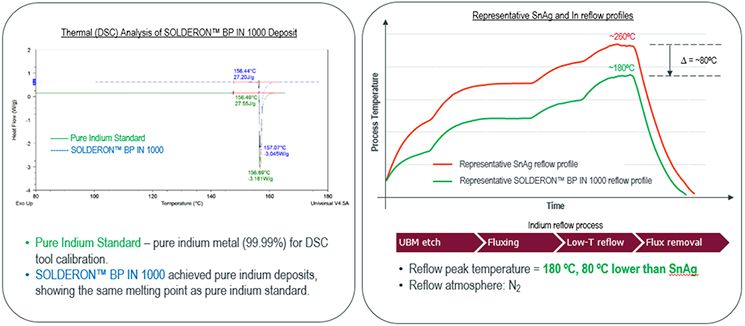
图3:Solderon™BP IN 1000铟达到低温回流,比SnAg低80°。
Solderon™BP IN 1000铟,多重回流:1X, 5X和10X
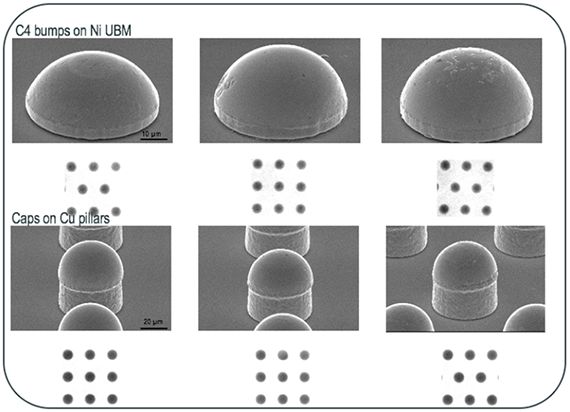
图4:Solderon™BP IN 1000铟在多次回流后显示无空洞性能。峰值回流温度= 180°C。
Solderon™BP IN 1000铟的电解时效性能

图5:Solderon™BP IN 1000铟浴性能显示在电解时效和热时效下稳定的电镀性能。电镀条件:2 ASD, 25°C。